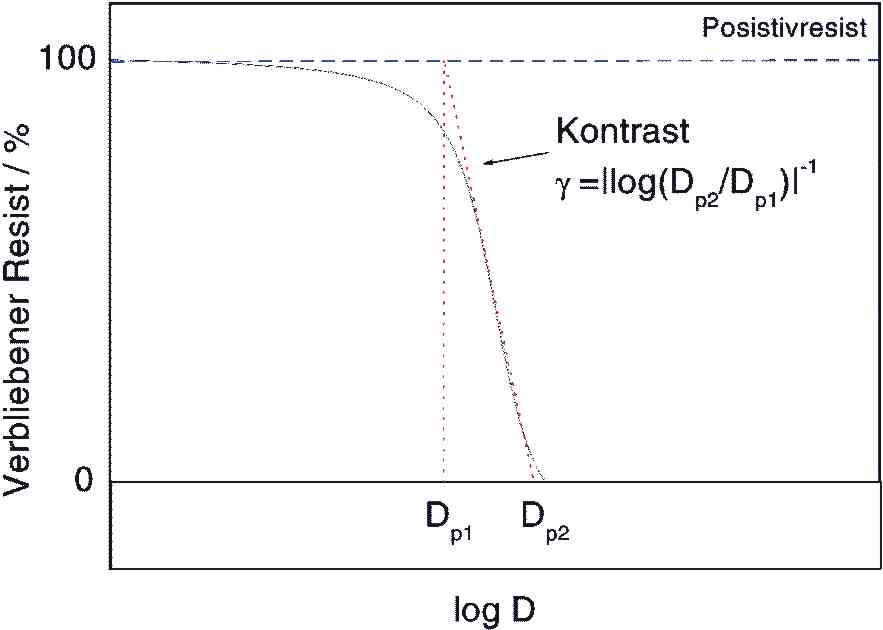
Im Gegensatz dazu werden bei einem Negativresist durch Elektronenbeschuss neue Bindungen zwischen den Polymerketten aufgebaut und somit das Molekulargewicht erhöht. Beim Entwickeln lösen sich hier die unbestrahlten Bereiche.
Als Parameter zur Charakterisierung der Resisteigenschaften dienen Auflösungsvermögen, Empfindlichkeit und Kontrast.
Nebenstehende Abbildungen zeigen schematisch die auf der Probe verbleibende Resistdicke in Abhängigkeit von der Bestrahlungsdosis D der Elektronen. Dp1 und Dn1 sind die höchsten Dosen, bei dem noch keine Kettenbrüche (Posistivresist) bzw. Verkettungen (Negativresist) stattfinden. Sie werden durch Extrapolation des 'linearen' Bereichs während des Abfalls der Kurve ermittelt. Bei Dp2 und Dn2 ist der Film vollständig belichtet, und dieser Punkt gibt die Empfindlichkeit des Resists an. Die Steigung des 'linearen' Anteils der Kurven ist ein Maß für den Kontrast eines Resists.
Idealerweise sollte ein Resist eine hohe Empfindlichkeit (kleines Dp2 bzw. Dn2 ), einen hohen Kontrast g (große Steigung, hohes g; Definition siehe auch nebenst. Abb.) und ein hohes Auflösungsvermögen miteinander vereinen. Doch alle Eigenschaften zu optimieren ist schwer, so dass oft ein hohes Auflösungsvermögen mit geringer Empfindlichkeit oder geringem Kontrast zusammenkommt. Gerade der Kontrast ist in Hinsicht auf Proximity- und Biaseffekte (d.h. Nachbarschaftseffekte durch Rückstreuung von Elektronen am Substrat. Sie führen zur ungewollten Verbreiterung der belichteten Bereiche im Resist und zu Mitbelichtung benachbarter Strukturen. Nicht zu verwechseln mit dem exchange-bias-Effekt!) wichtig, denn eine flache Gradationskurve bedeutet, dass auch bei kleineren Dosen ein erheblicher Teil des Resists belichtet wird. Diese Effekte möchte man gerade vermeiden, denn es ist oft von Interesse scharfe, senkrechte Seitenwände bei Strukturen zu erhalten. Eine ausführlichere Beschreibung findet sich in [RM91, MR97].
Ein typischer Vertreter der Positivresists ist Polymethylmethacrylat (PMMA), eines der ersten für die Elektronenstrahl-Lithographie entdeckten Materialien. Dieser Resist besitzt eine hohe Auflösung (~ 10 nm) und einen hohen Kontrast (g = 9), hat aber eine geringe Empfindlichkeit, die von der Energie der eingestrahlten Elektronen abhängt. So ist Dp1 mit 350 µC/cm2 bei 50 kV [MR97] mehr als doppelt so hoch als bei 20 kV [Pic97] . Ebenso ist zu beachten, dass PMMA nicht nur als Positivresist, sondern auch als Negativresist genutzt werden kann. Belichtet man mit mehr als der 10-fachen optimalen Dosis, setzen Verkettungen im Resist ein und führen zu den oben beschriebenen Eigenschaften des Negativresists.
Es werden auch PMMA-Copolymere, wie z.B. PMMA-MA, als Positivresist verwendet. Sie besitzen eine höhere Empfindlichkeit, aber dafür einen schlechteren Kontrast (g = 3) und geringeres Auflösungsvermögen (400 nm) [MR97]. Als Entwickler dient z.B. 4-Methyl-2-Pentanon mit Isopropanol. Weitere Positivresists sind PBS auf Poly(butene-1-sulfone)-Basis, die zwar den Vorteil haben, hundertmal empfindlicher als PMMA zu sein (1 µC/cm2), aber dafür eine schlechtere Auflösung besitzen (250 nm - 400 nm).
Einen guten Kompromiss bietet ein Copolymer aus Chlormethacrylaten und -methylstyrenen, ZEP. Er besitzt eine Empfindlichkeit zwischen 15 µC/cm2 und 30 µC/cm2, also fast eine Größenordnung besser als PMMA, liegt aber mit der Auflösung im gleichen Bereich wie PMMA.
Bei den Negativresists seien noch COP, ein Copolymer aus Glycidylmethacrylat und Ethylacrylat, und Polystyrol erwähnt. COP hat eine hohe Empfindlichkeit (0,3 µC/cm2), aber ein schlechtes Auflösungs-vermögen von 1 µm. Bei Polystyrol ist die Auflösung ähnlich und die Em-pfindlichkeit liegt bei 100 µC/cm2.
[RM91] I. Ruge, M. Mader, Halbleiter-Technologie, Springer Verlag, (1991).
[MR97] M.A. McCord, M.J. Rocks, Electron Beam Lithography, In: Handbook of Microlithography, Micromachining and Microfabrication, Vol.1 (Ed. P. Rai-Choudhury) (1997).
[Pic97] M. Picco, Diplomarbeit, Universität Kaiserslautern (1997).

